5G 通讯对5G线路板的技术要求
5G通讯在峰值速率、频谱效率、时延等方面都发生了重大变化,电路板IC高度集成、大功率,单位面积上连接更多的元件数量,采用高密互联设计,这给PCB和覆铜板材料提出了新的要求,本文重点介绍5G通讯对PCB及高速覆铜板技术要求。
电子通讯产品发展经历了 1G、2G、3G、4G等几个阶段,目前正迈向第 5 代通讯产品阶 段,作为第5代电子通讯,与 4G 相比,5G 在峰值速率、频谱效率、时延等方面都发生了重 大变化,这给 PCB 和覆铜板材料提出了新的要求,
5G线路板5G 关键技术指标分析
5G产品将给大家带来无限美好的移动互联憧憬和体验,从技术上来讲,需要面对很多 挑战,通过解决这些问题,必将带来很多技术上的突破和提升。
在5G 时代,会有大量MIMO天线应用,在Massive MIMO 天线中,由于天线通道数量 的增加,每个天线通道在功率放大器中所对应的通道数也会相应增加,而这一变化会导致功率放大器的整体功率增加,从而需要功率放大器具备更高的功率效率,而作为提升功率效率的办法之一,如何降低承载功率放大器的PCB 板材的损耗、提升PCB 板材的导热率变得尤为重要。
另外,MassiveMIMO 天线中辐射单元数量增加,要求PCB 板材的硬度更高,以提供更好的支撑效果,并且电路的复杂度增加,较传统双面 PCB 天线而言,多层板天线应用会越来越多。
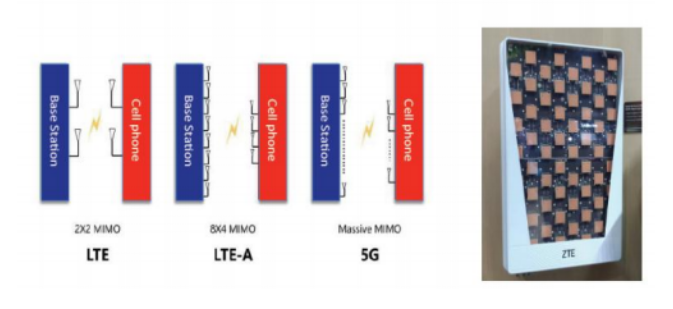
5G PCB 技术要求和技术难点
2-1 5G 通讯对 PCB 技术要求
随着通讯产品体积小型化、容量反而增加的趋势下,严重挤压了产品前端的设计空间, 为了缓解这种设计压力,通讯芯片厂商只有选择研发更高速率的IC 产品,以满足大容量、小体积的产品需求。然而速率增加后对于信号完整性工程师的压力并未缓解反而加重,高速率产品可以使用更少的走线来实现,但速率的增加直接导致信号质量的严要求,且裕量越来越少。在10Gbps 信号下,信号的UI 可以达到100ps 的位宽,但在25Gbps 信号下,信号的位宽只有40ps,这就意味着在通道的每一个环节都要进行优化设计来争取每一个ps 的裕量。
上图是一条典型的高速系统全链路示意图,从Driver IC 的封装开始到Receiver IC 的封装 结束,这其中包含IC封装设计、子卡1PCB设计、背板PCB 设计、子卡2PCB设计。对于高速率信号,需要保证主板PCB的成功设计和加工才能保证整条通道信号质量。
5G通讯,作为第五代移动通讯产品,应用了很多新的技术,但无论如何都离不开PCB这个载体,对于PCB的要求越来越严苛,尤其是对于PCB基板材料、加工工艺、表面处理等提出非常高的要求。
5G通讯产品工作频率不断攀升,对印制板制作工艺带来新要求,毫米波PCB通常是多层结构,微带线和接地共面波导电路通常位于多层结构的最外层。毫米波在整个微波领域中属于极高频率(EHF)范围,频率越高,要求的电路尺寸精度要越高。 2.1.1 5G与4G 对PCB工艺能力要求对比

2.1.2 外观控制要求:关键区域微带线不允许出现凹坑划伤类缺陷,因为高频PCB的线路传送的不是电流,而是高频电脉冲信号,高频导线上的凹坑、缺口、针孔等缺陷会影响 传输,任何这类小缺陷都是不允许的。
2.1.3 控制微带天线拐角:为改善天线的增益、方向与驻波;避免谐振频率往高频偏, 提高天线设计的裕量,需要对微带天线贴片拐角(Corner sharpness control)进行严控(EA),如 ≤20um、30um 等。
2.1.4 对于单通道 112G 高速产品,就要求 PCB 覆铜板材料具有较低的 Dk 和 Df,需要 新型树脂、玻璃布及铜箔技术,要求 PCB 工艺背钻精度更高,厚度公差控制更加严格,孔径更小等。
2.1.5 HDI 高密技术应用:5G 时代产品对于 PCB 技术需求,包含二阶 HDI 技术应用, 多次层压技术,不对称设计,0.15mm 微小孔,0.20mm 高密孔壁间距、不同体系材料混压等。
2-2 5G 通讯 PCB 技术难点
5G芯片要求PCB 孔间距更小,最小孔壁间距达 0.20mm,最小孔径 0.15mm,如此高密 布局对CCL 材料和 PCB 加工工艺都带来巨大挑战,如 CAF 问题,受热孔间裂纹问题等。
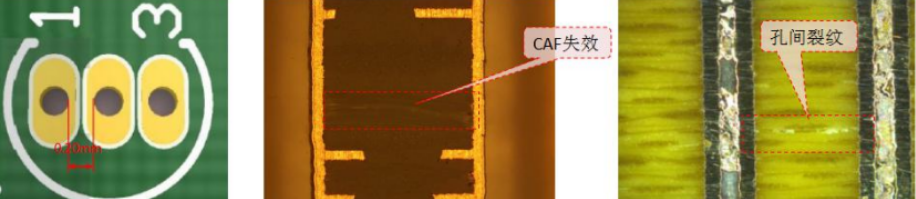
0.15mm 微小孔径,最大纵横比超过 20:1,如何防止钻孔时断针问题,如何提升 PCB 电 镀纵横比能力、防止孔壁无铜问题等,是目前 PCB 工艺急需解决的难题。

2-3 焊盘起翘
高速高频PCB 为减少信号损耗,希望采用高速材料,并且孔环尽可能小,从孔环5.0mil 减小到3.0mil,但高速材料铜箔与树脂结合力比常规FR4 材料要低,再使用小孔环,PCB 在经过回流或波峰焊时,由于热应力冲击,就发生焊盘起翘或表层PP 树脂开裂缺陷,见下图2-5。
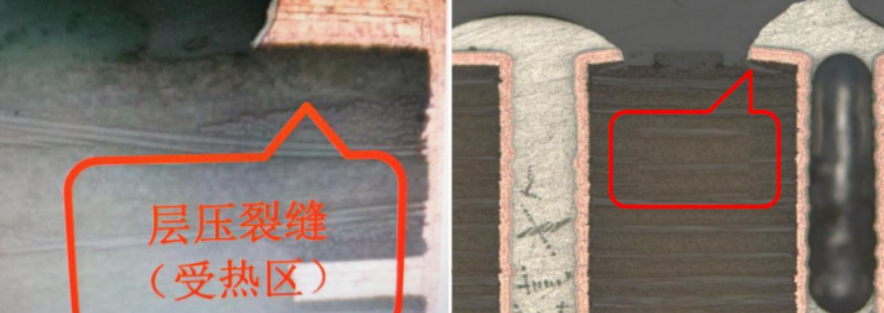
解决方案:高速发展是趋势,孔环会越来越小,为减少焊盘起翘或 PP 层开裂缺陷,需 要在树脂流动性和压合工艺参数上进行工艺优化。
电路板厂讲5G时代为电路板行业带来了前所未有的机遇与挑战。我们深知技术创新和工艺优化的重要性。未来,我们将继续深耕高频高速、高密度集成和高效散热等技术领域,为5G设备提供高性能、高可靠性的电路板解决方案,助力5G技术的普及与应用,推动全球通信产业的持续发展。
ps:部分图片来源于网络,如有侵权,请联系我们删除
推荐深联新闻
- 深联电路荣膺2024年度“绿色制造与环保优秀企业”称号
- 珠海深联招聘专场,它来啦!
- 电池 FPC:电子设备供电连接的柔性基石
- 当 PCB 厂遇上 AI:是挑战,还是开启 “智能电路” 新赛道的钥匙?
- 解码线路板厂精密工艺:如何将基板雕琢成电子设备 “心脏”?
- 探秘汽车智能座舱线路板:复杂电路如何适配多变需求?
- 5G 时代,HDI 面临哪些关键挑战与发展机遇?
- 手机无线充软板,如何为便捷充电 “搭桥铺路”?
- 汽车激光雷达线路板为何需要耐极端温度?普通 PCB 为何无法替代?
- PI 基材为何仍是柔性电路板的主流选择?




总共 - 条评论【我要评论】